
Spin type cleaning system compatible with high definition photomask
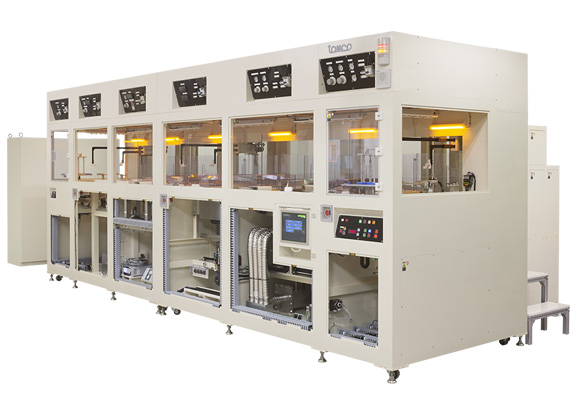
The following performance table shows the results obtained when cleaning is performed using functional water, such as Ozone water and Ammonia-added Hydrogen water, without the use of chemical solutions such as SPM (Sulfuric acid + hydrogen peroxide) and SC-1 (Ammonia water + hydrogen peroxide + DIW).
| PSM final clean (SPM free) | |||
|---|---|---|---|
| Category | No. | Item | Specification |
| Blank | 1 | Particle Free | >32nm |
| 2 | PRE% | ≧95% | |
| Image Layer (pattern side) |
3 | Remaining Soft defect on QZ | ≧0.05um (Yield : 98%) |
| 4 | Remaining Soft defect on Shifter | ≧0.05um, ≦10ea (Yield : 98%) | |
| 5 | SRAF (Dark) missing | No missing | |
| 6 | Pattern damage, ESD, Scratch | No damage | |
| 7 | Shifter change (Phase) | ≦-0.2 degree, average by 10X clean | |
| 8 | Shifter change (Trans.) | ≦0.025%, average by 10X clean | |
| 9 | Shifter change (CD mean) | ≦0.15nm, average by 10X clean | |
| 10 | Shifter change (CD Range) | ≦0.5nm, average by 10X clean | |
| Ion residues | 11 | Chemical residue (SO4) | ≦0.5 ppb |
| 12 | Chemical residue (NH4) | ≦17.0 ppb | |
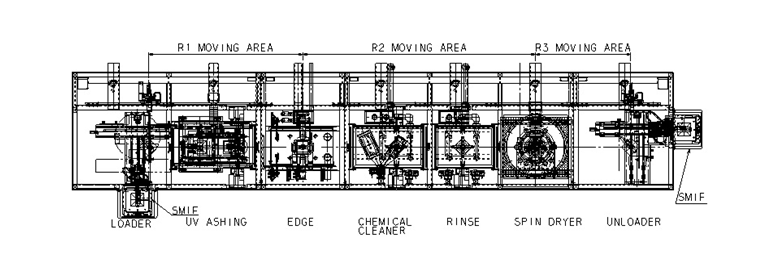
| Cleaning device body | 7300㎜(W) x 1410㎜(D) x 2300㎜(H) | Power BOX | 1400㎜(W) x 500㎜(D) x 2150㎜(H) |
|---|---|
| Chemical BOX | 2500㎜(W) x 700㎜(D) x 2000㎜(H) |
| Filter BOX | 2600㎜(W) x 700㎜(D) x 2000㎜(H) |
| Hot DIW Unit | 1250㎜(W) x 550㎜(D) x 1750㎜(H) |
| H2 water・CO2 water Unit | 1050㎜(W) x 1500㎜(D) x 2000㎜(H) |
| O3 water Unit | 570㎜(W) x 850㎜(D) x 2000㎜(H) |
| Utility | Three phase 200V & Single phase 100V DIW & Cooling water Clean dry air & Nitrogen gas General exhaust, Acid exhaust & Alkaline exhaust |
|---|